1. CVD 기본에 대한 이해
기본적으로 반도체 장비에서 Film을 만들고 나면 불필요한 by product는 evacuate 가 원활해야 하고, 지속적으로 재현성 있게 잘 구현되어야 합니다. 300mm Fab 장비는 보통 CLN Room에 메인 장비를 놓고, 기타 장비 Component는 2F(Chiller, Power Box, Heat Exchanger), 그리고 1F에는 (Pump, Gas공급 장치)등을 둡니다.
보통 메인 장비에서 Wafer가 Chamber로 이동하여 증착하는데 일반적인 순서는 다음과 같습니다.
FOUP at Load Port -> Front Robot
Front Robot -> Aligner -> Load Lock ->TM(Transfer Module) -> Chamber -> TM -> Load Lock -> Front Robot -> Foup at Load Port
PE CVD의 경우 증착에 필요한 Gas를 넣고 챔버 내 Flow 한 후 챔버 상부 Shower head 상부에 무수히 많은 구멍을 통해 분사되고 동시에 Plasma가 On 되면서 원하는 Film을 웨이퍼 기판에 증착하고 나머지 부산물을 휘발성으로 Evacuate 되어 배출됩니다.
각 개별 장비의 특성을 위해 반드시 만족해야 하는 조건들이 있습니다.
THK Target, THK Uniformity, Particle을 필수적인 조건으로 맞춰야 합니다. Center와 Edge 부위에 얼마나 균일하게 증착되었는지 측정값으로 산출하는 지수를 Uniformity라고 합니다.
Uniformity (%) = THK Range(Max-Min) / ( 2 × THK Average ) × 100
추가로 Deposition 되는 장비에서는 Deposition Rate가 중요 관리 인자입니다. 물질의 특성과 웨이퍼 가공시간에 영향을 주어 Throughput에 직접적 영향을 줍니다.
DR(Å/min) = 증착된 Thickness(Å) / Deposition Time(s) × 60
CVD Film은 Wet Etch Rate도 주요 특성이며 Oxide 박막을 Wet Chemical에 의해 시간당 제거되는 양을 측정하고 절연막 물질의 특성을 잘 알려 주어 항상 일정하게 유지 관리 해야 합니다.
WER(Å/Sec) = 제거되는 Thickness량 ((전 THK - WET Etch후 THK)) / Deposition Time(s)
WER은 tHERMAL Oxide 대비하여 CVD Film이 Etch 된 양으로 상대적으로 비교 점검됩니다. WER진행 시 BOE Chemical과 Temp의 민감한 차이로 WET Batch가 잘 관리되어야 합니다.
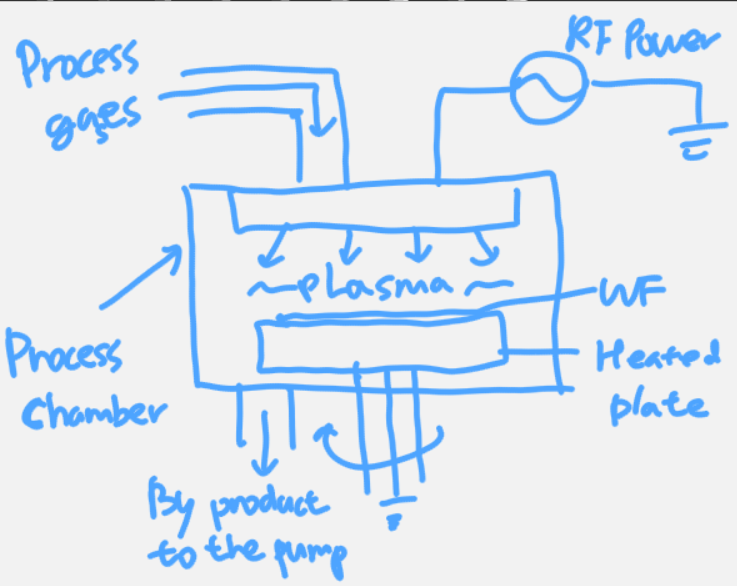
'반도체 기술' 카테고리의 다른 글
| CVD 주요 부품 특성 2 (3) | 2023.02.18 |
|---|---|
| Self-Bais (1) | 2023.02.18 |
| CVD 주요 부품 특성 (4) | 2023.02.16 |
| Semiconductor & Fermi Level (7) | 2023.02.15 |
| Diff 공정 - Oxidation (14) | 2023.02.14 |



