1-2.이온 주입 공정 방법
우리가 이온 주입을 할 때는 Ion Implanter 장비를 사용하여 Wafer에 이온을 넣어줄 수 있습니다.기기는 크게 3가지로 구성 됩니다. (Ion Source, Bean Line, End station)
Ion source는 필라멘트에 전류를 흘려주어 열전자를 방출하고, Arc Voltage와 Arc Current 조절을 통해 dopant gas로부터 주입 이온을 형성하고 Ion source를 만들어 냅니다. 이렇게 형성된 이온을 extration voltage와 current를 통해 일정 에너지를 가지도록 ion source를 형성하고 analyzer를 통해 원하는 원자량을 가진 주입 이온만 추출합니다.
Bean line은 ion을 집속 시켜 beam을 형성하는 부분으로 가속기에서 여분의 가속 에너지를 만들어 줍니다.
End station에서는 wafer에 이온을 주입하는 부분으로 형성된 beam을 slit을 통과하여 line 형태로 wafer에 주입합니다. 한장의 wafer가 상하로 이동하며 전면에 균일한 이온 주입이 가능합니다.
1-3. Annealing
이온 주입 공정이란 것은 Physical적으로 Wafer에 Ion을 때리는 것이므로 Si에 큰 피해를 주게 됩니다. 주입된 Ion이 전자를 내놓으려면 Si 격자 위치에 들어가야 하는데 그렇지 않은 경우 다시 잡아 주기 위해 고온 열처리를 해주게 됩니다.
Annealing 공정은 Damage 받은 실리콘 격자 손상 복구를 위해 사용되며 Dopant activation 즉, 주입된 불순물의 전기적 활성화를 위해 사용됩니다.
1-4. 4 Point probe
짧은 측정 시간, 정확한 값, Size 에 큰 영향 받지 않고 측정이 가능하지만, 발생하는 열로 전압 차가 야기 되고 사용한 wafer는 접촉 부분에 의해 손상되어 사용할 수 없습니다. 양산 시 측정 불가합니다.
1-5. Channeling effect(채널링 효과)
이온 주입 공정에서 채널링 효과는 중요한 문제이므로 따로 할애하여 정리해 보겠습니다. 원자들은 다양한 결정면을 지니고 있습니다. ION IMPLANTATION이 시작되는 순간 WAFER에 존재하는 실리콘 결정면이 왼쪽과 같으면 우리가 원하는 깊이에 DOPING할 수 있다고 가정해 봅시다. 그러나 WAFER에 있는 모든 실리콘들이 동일한 결정면을 지니고 있지 않습니다. 만약 오른쪽과 같은 결정면을 지니면 기다란 통로가 생겨 주입된 이온이 부딪히지 않고 계속해서 깊숙히 내려가게 됩니다. 이러한 현상을 채널링 효과라고 합니다.즉, 예측보다 이온이 더 깊이 들어가는 현상입니다. 이를 방지하기 위한 방법에는 여러가지가 있습니다.
1) Tilting, Twisting : Wafer를 돌리거나 기울여 주입하는 이온의 방향성을 감소 시키는 방법입니다.
2) 무겁고 큰 이온을 주입합니다. 채널 입구보다 큰 크기의 이온을 사용하면 통로로 들어가는 현상이 줄어듭니다.
3) Pre-amorpahization : wafer 표면에 미리 damage를 줍니다. wafer 표면은 손상되어 미리 damage를 입혀 표면을 비정질로 만들어줘서 채널링 효과를 줄이는 방법입니다.
4) Wafer 표면에 산화막을 깔아 주고 ION 주입을 합니다. Pre-amorphization처럼 wafer 표면ㅇ ㅔ미리 변화를 주어 작동하는 원리입니다.
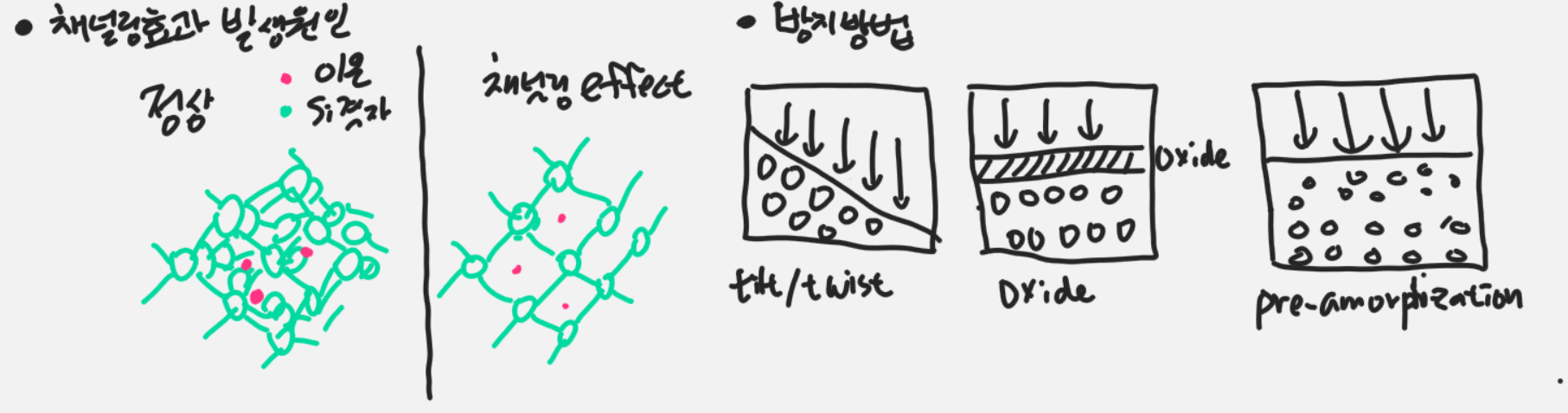
'반도체 기술' 카테고리의 다른 글
| 반도체 기술 - 친수성과 소수성 그리고 반도체 소자에 영향을 주는 오염물 (0) | 2022.11.18 |
|---|---|
| 반도체 8대 기술 - CMP 공정 (0) | 2022.11.15 |
| 반도체 8대 기술 - IMP 공정 (2) | 2022.11.13 |
| 반도체 8대 기술 - CLEAN 공정 SPM, DHF, BOE (0) | 2022.11.11 |
| 반도체 8대 기술 - 인산세정, 초음파 세정, 에어로졸 세정 (0) | 2022.11.10 |